اگرچه هر دو ویفر سیلیکونی و شیشهای هدف مشترکی به نام «تمیز شدن» دارند، اما چالشها و حالتهای خرابی که در طول تمیز کردن با آنها مواجه میشوند، بسیار متفاوت است. این اختلاف ناشی از خواص ذاتی مواد و الزامات مشخصات سیلیکون و شیشه و همچنین «فلسفه» متمایز تمیز کردن ناشی از کاربردهای نهایی آنهاست.
اول، بیایید روشن کنیم: دقیقاً چه چیزی را تمیز میکنیم؟ چه آلایندههایی درگیر هستند؟
آلایندهها را میتوان به چهار دسته تقسیم کرد:
-
آلایندههای ذرهای
-
گرد و غبار، ذرات فلزی، ذرات آلی، ذرات ساینده (از فرآیند CMP) و غیره
-
این آلایندهها میتوانند باعث ایجاد نقص در الگو، مانند اتصال کوتاه یا مدار باز شوند.
-
-
آلایندههای آلی
-
شامل بقایای مواد مقاوم در برابر نور، افزودنیهای رزین، روغنهای پوست انسان، بقایای حلال و غیره میشود.
-
آلایندههای آلی میتوانند پوششهایی تشکیل دهند که مانع از اچینگ یا کاشت یون شده و چسبندگی سایر لایههای نازک را کاهش میدهند.
-
-
آلایندههای یون فلزی
-
آهن، مس، سدیم، پتاسیم، کلسیم و غیره که عمدتاً از تجهیزات، مواد شیمیایی و تماس انسان ناشی میشوند.
-
در نیمهرساناها، یونهای فلزی آلایندههای «کشنده» هستند و سطوح انرژی را در باند ممنوعه وارد میکنند که جریان نشتی را افزایش میدهد، طول عمر حامل را کوتاه میکند و به خواص الکتریکی آسیب جدی میرساند. در شیشه، آنها ممکن است بر کیفیت و چسبندگی لایههای نازک بعدی تأثیر بگذارند.
-
-
لایه اکسید بومی
-
برای ویفرهای سیلیکونی: یک لایه نازک از دی اکسید سیلیکون (اکسید طبیعی) به طور طبیعی روی سطح در هوا تشکیل میشود. کنترل ضخامت و یکنواختی این لایه اکسید دشوار است و باید در طول ساخت ساختارهای کلیدی مانند اکسیدهای گیت به طور کامل برداشته شود.
-
برای ویفرهای شیشهای: خود شیشه یک ساختار شبکهای سیلیسی است، بنابراین مشکلی در «حذف لایه اکسید بومی» وجود ندارد. با این حال، ممکن است سطح به دلیل آلودگی اصلاح شده باشد و این لایه باید حذف شود.
-

I. اهداف اصلی: واگرایی بین عملکرد الکتریکی و کمال فیزیکی
-
ویفرهای سیلیکونی
-
هدف اصلی تمیز کردن، تضمین عملکرد الکتریکی است. مشخصات معمولاً شامل تعداد و اندازه دقیق ذرات (مثلاً ذرات ≥0.1μm باید به طور مؤثر حذف شوند)، غلظت یونهای فلزی (مثلاً Fe، Cu باید تا ≤10¹⁰ اتم در سانتیمتر مربع یا کمتر کنترل شوند) و سطح باقیماندههای آلی است. حتی آلودگی میکروسکوپی میتواند منجر به اتصال کوتاه مدار، جریان نشتی یا خرابی یکپارچگی اکسید گیت شود.
-
-
ویفرهای شیشهای
-
به عنوان زیرلایه، الزامات اصلی، کمال فیزیکی و پایداری شیمیایی هستند. مشخصات بر جنبههای سطح کلان مانند عدم وجود خراش، لکههای غیرقابل پاک شدن و حفظ زبری و هندسه سطح اصلی تمرکز دارند. هدف از تمیز کردن در درجه اول تضمین تمیزی بصری و چسبندگی خوب برای فرآیندهای بعدی مانند پوششدهی است.
-
دوم. ماهیت مواد: تفاوت اساسی بین بلوری و آمورف
-
سیلیکون
-
سیلیکون یک ماده بلوری است و سطح آن به طور طبیعی یک لایه اکسید دی اکسید سیلیکون (SiO₂) غیر یکنواخت رشد میکند. این لایه اکسید برای عملکرد الکتریکی خطرناک است و باید به طور کامل و یکنواخت برداشته شود.
-
-
شیشه
-
شیشه یک شبکه سیلیس آمورف است. ماده تودهای آن از نظر ترکیب مشابه لایه اکسید سیلیکون سیلیکون است، به این معنی که میتواند به سرعت توسط اسید هیدروفلوئوریک (HF) حکاکی شود و همچنین مستعد فرسایش قلیایی قوی است که منجر به افزایش زبری یا تغییر شکل سطح میشود. این تفاوت اساسی نشان میدهد که تمیز کردن ویفر سیلیکونی میتواند حکاکی نوری و کنترلشده را برای حذف آلایندهها تحمل کند، در حالی که تمیز کردن ویفر شیشهای باید با دقت بسیار زیادی انجام شود تا از آسیب رساندن به ماده پایه جلوگیری شود.
-
| مورد تمیز کردن | تمیز کردن ویفر سیلیکونی | تمیز کردن ویفر شیشه ای |
|---|---|---|
| هدف تمیز کردن | شامل لایه اکسید بومی خود است | روش تمیز کردن را انتخاب کنید: ضمن محافظت از مواد پایه، آلایندهها را حذف کنید |
| تمیز کردن استاندارد RCA | - اس پی ام(H₂SO₄/H₂O₂): باقیماندههای آلی/مقاوم در برابر نور را حذف میکند. | جریان اصلی تمیز کردن: |
| - SC1(NH₄OH/H₂O₂/H₂O): ذرات سطحی را از بین میبرد | عامل تمیزکننده قلیایی ضعیفحاوی عوامل سطحی فعال برای حذف آلایندههای آلی و ذرات | |
| - دی اچ اف(اسید هیدروفلوئوریک): لایه اکسید طبیعی و سایر آلایندهها را از بین میبرد. | شوینده قلیایی قوی یا قلیایی متوسط: برای حذف آلایندههای فلزی یا غیرفرار استفاده میشود. | |
| - SC2(HCl/H₂O₂/H₂O): آلایندههای فلزی را حذف میکند | از HF در کل اجتناب کنید | |
| مواد شیمیایی کلیدی | اسیدهای قوی، قلیاهای قوی، حلالهای اکسیدکننده | شوینده قلیایی ضعیف، به طور خاص برای حذف آلودگی ملایم فرموله شده است |
| وسایل کمکی فیزیکی | آب دیونیزه (برای شستشوی با خلوص بالا) | شستشوی اولتراسونیک، مگاسونیک |
| فناوری خشک کردن | خشک کردن با بخار مگاسونیک، IPA | خشک کردن ملایم: بلند کردن آهسته، خشک کردن با بخار IPA |
III. مقایسه محلولهای پاککننده
بر اساس اهداف و ویژگیهای مواد ذکر شده، محلولهای تمیزکننده برای ویفرهای سیلیکونی و شیشهای متفاوت هستند:
| تمیز کردن ویفر سیلیکونی | تمیز کردن ویفر شیشه ای | |
|---|---|---|
| هدف تمیز کردن | حذف کامل، از جمله لایه اکسید اصلی ویفر. | حذف انتخابی: حذف آلایندهها ضمن محافظت از زیرلایه. |
| فرآیند معمول | تمیز کردن استاندارد RCA:•اس پی ام(H₂SO₄/H₂O₂): مواد آلی سنگین را حذف میکند/مقاوم در برابر نور •SC1(NH₄OH/H₂O₂/H₂O): حذف ذرات قلیایی •دی اچ اف(HF رقیق): لایه اکسید بومی و فلزات را حذف میکند •SC2(HCl/H₂O₂/H₂O): یونهای فلزی را حذف میکند | جریان تمیز کردن مشخصه:•پاک کننده قلیایی ملایمبا سورفکتانتها برای حذف مواد آلی و ذرات •پاک کننده اسیدی یا خنثیبرای حذف یونهای فلزی و سایر آلایندههای خاص •در طول فرآیند از HF اجتناب کنید |
| مواد شیمیایی کلیدی | اسیدهای قوی، اکسیدکنندههای قوی، محلولهای قلیایی | پاککنندههای قلیایی ملایم؛ پاککنندههای تخصصی خنثی یا کمی اسیدی |
| کمک فیزیکی | مگاسونیک (حذف ذرات با راندمان بالا و ملایم) | اولتراسونیک، مگاسونیک |
| خشک کردن | خشک کردن مارانگونی؛ خشک کردن بخار IPA | خشک کردن با کشش آهسته؛ خشک کردن با بخار IPA |
-
فرآیند تمیز کردن ویفر شیشه ای
-
در حال حاضر، اکثر کارخانههای فرآوری شیشه از روشهای تمیزکاری بر اساس ویژگیهای مواد شیشه استفاده میکنند و عمدتاً به مواد تمیزکننده قلیایی ضعیف متکی هستند.
-
ویژگیهای عامل تمیزکننده:این مواد تمیزکننده تخصصی معمولاً قلیایی ضعیفی دارند و pH آنها حدود ۸-۹ است. آنها معمولاً حاوی سورفکتانتها (مثلاً آلکیل پلیاکسیاتیلن اتر)، عوامل کیلیتساز فلزی (مثلاً HEDP) و مواد کمکی تمیزکننده آلی هستند که برای امولسیون کردن و تجزیه آلایندههای آلی مانند روغن و اثر انگشت طراحی شدهاند، در حالی که حداقل خورندگی را برای ماتریس شیشه دارند.
-
جریان فرآیند:فرآیند تمیز کردن معمول شامل استفاده از غلظت خاصی از مواد تمیزکننده قلیایی ضعیف در دماهای مختلف از دمای اتاق تا 60 درجه سانتیگراد، همراه با تمیز کردن اولتراسونیک است. پس از تمیز کردن، ویفرها تحت چندین مرحله شستشو با آب خالص و خشک کردن ملایم (به عنوان مثال، بلند کردن آهسته یا خشک کردن با بخار IPA) قرار میگیرند. این فرآیند به طور موثر الزامات ویفر شیشهای را برای تمیزی بصری و تمیزی عمومی برآورده میکند.
-
-
فرآیند تمیز کردن ویفر سیلیکونی
-
برای پردازش نیمههادیها، ویفرهای سیلیکونی معمولاً تحت تمیزکاری استاندارد RCA قرار میگیرند، که یک روش تمیزکاری بسیار مؤثر است که قادر به رفع سیستماتیک انواع آلایندهها بوده و تضمین میکند که الزامات عملکرد الکتریکی برای دستگاههای نیمههادی برآورده شده است.
-
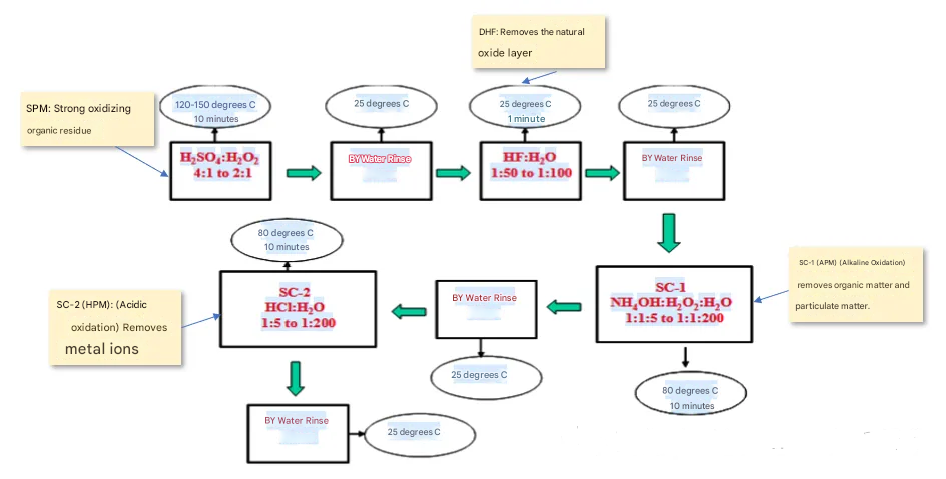
چهارم. وقتی شیشه استانداردهای بالاتری از «پاکیزگی» را برآورده میکند
وقتی ویفرهای شیشهای در کاربردهایی که نیاز به شمارش دقیق ذرات و سطوح یون فلزی دارند (مثلاً به عنوان زیرلایه در فرآیندهای نیمههادی یا برای سطوح رسوب لایه نازک عالی) استفاده میشوند، فرآیند تمیزکاری ذاتی دیگر ممکن است کافی نباشد. در این حالت، میتوان اصول تمیزکاری نیمههادی را اعمال کرد و یک استراتژی تمیزکاری RCA اصلاحشده را معرفی کرد.
هسته اصلی این استراتژی، رقیقسازی و بهینهسازی پارامترهای استاندارد فرآیند RCA برای تطبیق با ماهیت حساس شیشه است:
-
حذف آلایندههای آلی:محلولهای SPM یا آب حاوی اوزون ملایمتر میتوانند برای تجزیه آلایندههای آلی از طریق اکسیداسیون قوی استفاده شوند.
-
حذف ذرات:محلول بسیار رقیق SC1 در دماهای پایینتر و زمانهای عملیات کوتاهتر به کار گرفته میشود تا از دافعه الکترواستاتیکی و اثرات ریزحکاکی آن برای حذف ذرات استفاده شود، در حالی که خوردگی روی شیشه به حداقل میرسد.
-
حذف یون فلزی:برای حذف آلایندههای فلزی از طریق کیلیتسازی، از محلول رقیق SC2 یا محلولهای سادهی اسید هیدروکلریک رقیق/اسید نیتریک رقیق استفاده میشود.
-
ممنوعیتهای اکید:برای جلوگیری از خوردگی زیرلایه شیشهای، باید از DHF (دی آمونیوم فلوراید) کاملاً اجتناب شود.
در کل فرآیند اصلاحشده، ترکیب فناوری مگاسونیک به طور قابل توجهی راندمان حذف ذرات در اندازه نانو را افزایش داده و روی سطح ملایمتر است.
نتیجهگیری
فرآیندهای تمیز کردن ویفرهای سیلیکونی و شیشهای نتیجه اجتنابناپذیر مهندسی معکوس بر اساس الزامات نهایی کاربرد، خواص مواد و ویژگیهای فیزیکی و شیمیایی آنها است. تمیز کردن ویفر سیلیکونی به دنبال "تمیزی در سطح اتمی" برای عملکرد الکتریکی است، در حالی که تمیز کردن ویفر شیشهای بر دستیابی به سطوح فیزیکی "کامل و بدون آسیب" تمرکز دارد. از آنجایی که ویفرهای شیشهای به طور فزایندهای در کاربردهای نیمههادی مورد استفاده قرار میگیرند، فرآیندهای تمیز کردن آنها ناگزیر فراتر از تمیز کردن قلیایی ضعیف سنتی تکامل مییابد و راهحلهای اصلاحشدهتر و سفارشیتری مانند فرآیند RCA اصلاحشده برای دستیابی به استانداردهای بالاتر تمیزی ایجاد میکند.
زمان ارسال: ۲۹ اکتبر ۲۰۲۵
